BGA 焊盘设计及钢网常用开孔
1、BGA 焊盘设计
BGA类元件焊盘设计的主要依据—焊球的直径与间距:
焊接后焊球融化与锡膏及铜铂形成金属间化合物,此时球的直径变小,同时融化时的锡膏在分子间作用力及液体间张力的作用下回缩。
1)焊盘的设计一般较球的直径小10%-20%
2)激光钢网的开孔较焊盘大10%-20%

BGA类元件焊盘与钢网设计对照表
2、BGA 开孔规则
1.27pitch 开口Φ0.50—0.68MM
1.0pitch 开口Φ0.45—0.55MM
0.8pitch 开口Φ0.35—0.50MM
0.5pitch 开口Φ0.28—0.31MM
1、BGA开孔0.50mm,偏上限
2、BGA再流焊有自动对中效应,且短路不良比虚焊和空焊现象容易识辨,品质风险小些
3、观察09年Module维修情况,BGA空焊不良远高于短路不良
3、BGA 零件(一)——最常用开孔方式
原PAD 开孔后


直径:0.35mm 直径:0.50mm
内距: 0.45mm 内距: 0.30mm
整体图
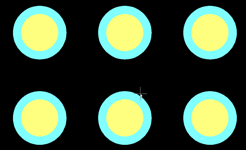
4、BGA 零件(二)
原PAD 开孔后


直径:0.35mm 直径:0.45mm
内距: 0.45mm 内距: 0.35mm
整体图
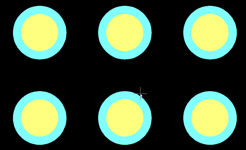
5、BGA 零件(三)——AMB
原PAD 开孔后


直径:0.40mm 直径:0.45mm
内距: 0.40mm 内距: 0.35mm
整体图
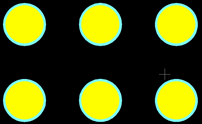

6、BGA 零件(四)——0.65 Pitch BGA
原PAD 开孔后
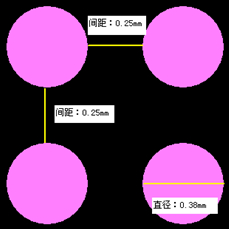
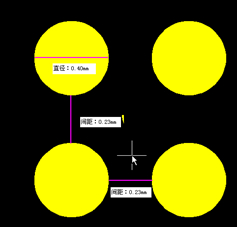
直径:0.38mm 直径:0.40mm
内距: 0.25mm 内距: 0.26mm
整体图



暂无评论,快来发表第一条评论吧~